
低速陽電子ビームラインとは,放射性同位元素のβ+崩壊によって発生した高速陽電子を減速(熱
化)し て,磁場によりビーム化した装置のことです.
低速化した陽電子を再度任意のエネルギーに加速して試料に打ち込むことで,任意の深さ位置で消滅γ線ドップラー拡がり測定を
おこなうことができます. 加速エネルギーは0-30keVまで変化させることができるので、試料の欠 陥深さ分布(表面〜数μm)を調べることができます.
さらに2本の半導体検出器を用いた同時計測ドッ
プラー拡がり測定を行うこ
ともでき,欠陥についてより詳細な議論が可能です.
この低速陽電子ビームライン1は常時試料測定をおこなっています.
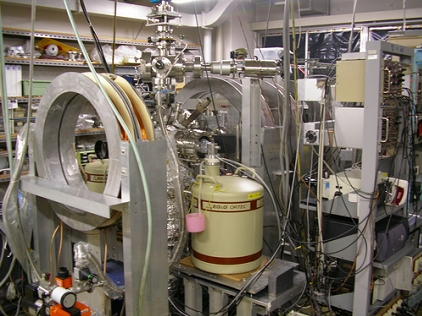 |
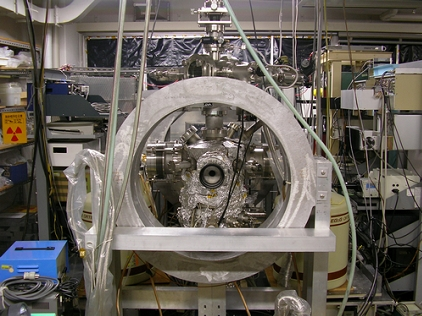 |
▲ Fig.1 装置全体
|
▲ Fig.2 装置試料部
|

測定対象は主に薄膜試料であるが,バルク試料も測定可能.例として半導体における陽電子の評価対象をFig.3に示
す.
基板やゲート絶縁膜などのフロントエンドプロセスから配線や層間絶縁膜などのバックエンドプロセスまで評価することが可能.
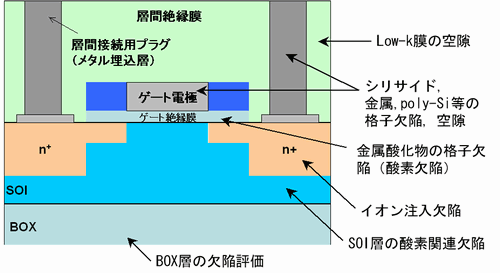
▲
Fig.3 半導体における陽電子の評価対象
|

単色光を試料に照射しながら消滅γ線のドップラー拡がりを測定するシステム.
(LASER:325nm,532nm,単色光:250-1200nm)
太陽電池やLEDといった受発光素子に用いられる材料等の電子を励起しながら測定することが可能.

▲Fig.4 光照射システム内部
(緑色光照射)
|

▲Fig.5 下流側から見た試料(赤色光照射)
|

試料の温度を変
化させながら消滅γ線のドップラー拡がりを測定す
るシステム.

通常のビームラインはビーム径が大きいため小型の試料の
計測で
はビームの利用効率が良くありませんでした.磁
界型レ
ンズを用いてビームを集束することでビーム全体を試
料に照射することが可能になり計測速度が向上します.
さらに3次元マニュピレーターを用いて試料位置を変えることで試料面位置での欠陥分布を測定することができます.

従来のアナログ測定システムでは,係数率が高くなると測定の分解能が悪くなるという問題があります.
また,信号処理モジュールは環境や経年劣化の影響を受けやすいため,安定した測定システムの開発が課題となっています.
上殿研究室ではDSP (Digital Signal Processor)
を用いた測定システムの立ち上げに取り組んでいます.
|



