
主に,開発用ビームライン:SLOW2を用いて開発して
います.応用加速器部門への移設作業を行いました.
作業風景はこちら.
現在は主にパルスシステムとビーム集束システムの開発を 行っています.
また,産業技術総合研究所に出向き,陽電子ビームによる計測に用いる様々なシステムの開発を行っていま す.

通常のビームラインはビーム径が大きいため試料の局所的な欠陥評価を行なうのが困難です.
しかし磁界型レンズを用いてビームを集束することで局所的な欠陥評価が可能になります.
さらに3次元マニュピレーターを用いて試料位置を変えることで試料面位置での欠陥分布を測定することができます.
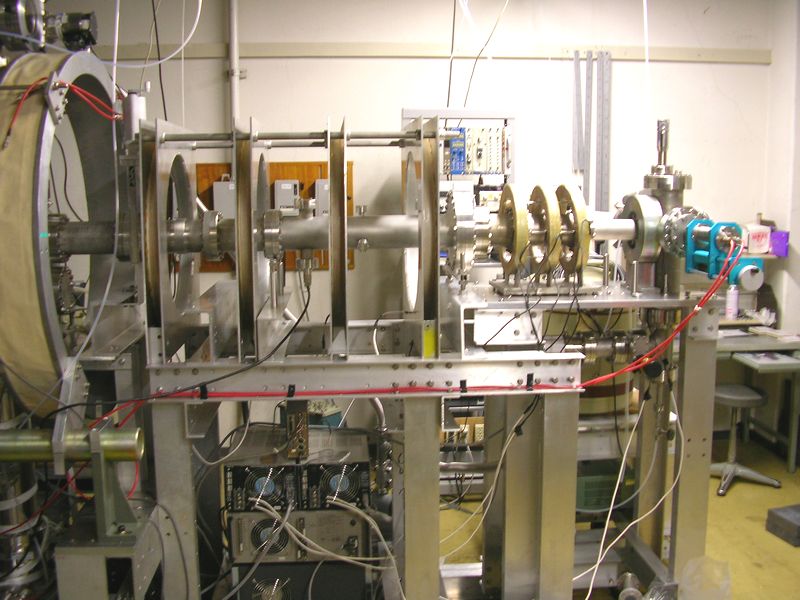 |
|
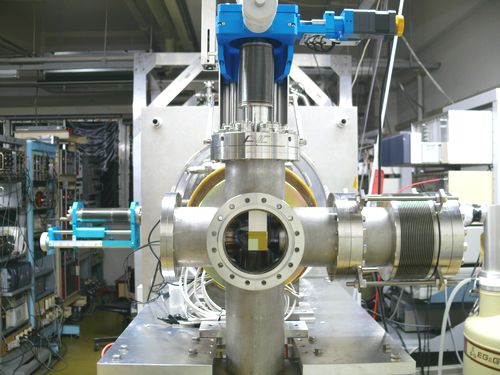 |
▲
Fig.1 欠陥マッピングシステム全体
|
|
▲
Fig.2 欠陥マッピングシステム試料部
|
 |
|
 |
▲ Fig.3 集束前のビーム径
|
|
▲ Fig.4 集束後のビーム径
|

▲ Fig.5 欠陥マッピングシステム用計測アプリケーション
|

低速陽電子ビームをパルス化して試料に打ち込むことで陽電子寿命を測定することができます.
パルス陽電子ビームは通常の低速陽電子ビームと同様に打ち込み深さを変えることができるので,任意の深さ位置での陽電子
寿命測定が可能になり, 薄膜試料の空孔型欠陥や空隙のサイズを推定することができるようになります.
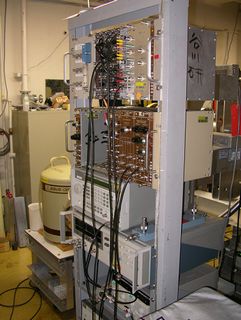 |
|
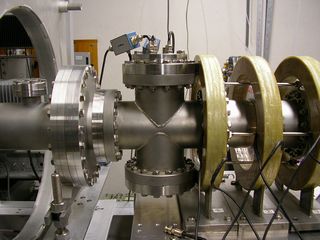 |
▲
Fig.1 パルス陽電子ビームライン モジュール部
|
|
▲ Fig.2 チョッパー導入部
|

複数の半導体検出器を用いることでγ線の検出効率を向上させ,ドップラー拡がり測定の計測時
間の短縮化を図る研究を行っています.

レーザーを試料に照射しながらドップラー拡がり測定を行うシステムの開発を行っています.現
在,SLOW1にて運用しています.
半導体光学素子材料の励起が可能な325 nm He-Cdレーザーを
はじめ,250-1200nmの範囲の単色光を照射することが可能です.
 |
|
 |
|
▲ Fig.1 光照射システム チャンバー内部
|
|
▲ Fig.2 光を照射した試料
|
|



