陽電子消滅による材料分析
上殿明良
筑波大学物理工学系 助教授
〒305−8573 茨城県つくば市天王台1−1−1
http://www.sakura.cc.tsukuba.ac.jp/~slowpos1
1. はじめに
材料分析と一言に言っても,膨大な手法があるが,これらを大雑把に微量分析と状態分析に分けて考えることがある.微量分析とは,たとえば,固体中の不純物,環境ホルモンやダイオキシンなど,材料や環境に本来存在する物質とは異質の物質を検出する手法である.状態分析とは,その異質の物質がどのような状態で母体に入り込んでいるかを検出,分析するという意味で使われることが多い.この意味で,「化学状態分析」と言えばより意味が明確になる.しかし,その母体を構成する原子や分子がどのような状態にあるかを分析する場合も状態分析に含めて良いだろう.一般に,このような分析は難しく,分析対象がナノレベルになれば,その難易度は高くなる.たとえば,白い床の大きな部屋に白い「おはじき」を隙間無く敷き詰めることを考えてみよう.そして,一つだけ赤いおはじきをもってきて,白いおはじきと交換しても,その交換した場所を見つけるのはそれほど難しくないだろう.しかし,今,おはじきを一つだけ抜く(白い床が見える),あるいは余分のおはじきをもう一つ持ってきて,一箇所だけ2重にしたらどうだろうか.それらの場所を見つけるのは,さきほどの赤いおはじきの場合に比較してかなり時間がかかるだろう.
陽電子消滅はこのおはじきを一つ抜いた場所,すなわち「空孔型欠陥」を効率良く見つけ出す手法である.陽電子を空孔型欠陥検出ツールとして用いたときの特徴を以下に示す.
1) 検出できる欠陥は,単一原子空孔から空隙,ポア(サイズ:数10 nm3)程度.
2) 空孔検出手法としては高感度(³1016 cm-3)かつ非破壊検査である.
3) 試料の温度,伝導性などの制限がない(液体でも可能).このため,陽電子で評価できる材料は,金属,半導体1),絶縁体2),高分子3)と広範囲である.
4) 試料最表面から数mmまでの欠陥深さ分布検出が可能.
本稿では,陽電子消滅の原理について簡単に述べた後,その応用例を紹介する.
2. 陽電子消滅の原理と空孔型欠陥の検出
陽電子は電子の反物質で,電子と同じ質量(m0)を持つが,その電荷は正(+q)である.通常,陽電子は,β+崩壊する放射性同位元素から得られる.陽電子は物質中に入射すると電子と対消滅するが,消滅により質量がエネルギー(光子)に転換される.陽電子・電子対の静止質量は2m0であるが,主に2個の光子が反対方向に放出されるため,一つの光子のエネルギーはアインシュタインの方程式よりm0c2(511 keV)となり,γ線に対応する.図1には放射性同位元素(22Na)から放出された陽電子と電子が消滅し,γ線を放出する様子を示した.

図1.陽電子-電子対消滅の模式図.
消滅前に電子が運動量を持つ場合(図中では右方向),対消滅の前後で運動量も保存されるため,γ線のエネルギー(Eg)はドップラー効果により511 keVから変化する.
Eg= m0c2 ± DEg. (1)
DEg=cpL/2で,pLはγ線放出方向の電子の運動量分布である.したがって,γ線のエネルギー分布を精密測定することにより,陽電子の消滅相手の電子のpLを決定できる.
図2(a)にSiの消滅γ線ドップラー拡がりを示す.スペクトルは主に分布が狭い成分(½pL½<10-2 m0c)と広い成分に分かれるが,それぞれ価電子との陽電子消滅および内殻電子との消滅に対応する.
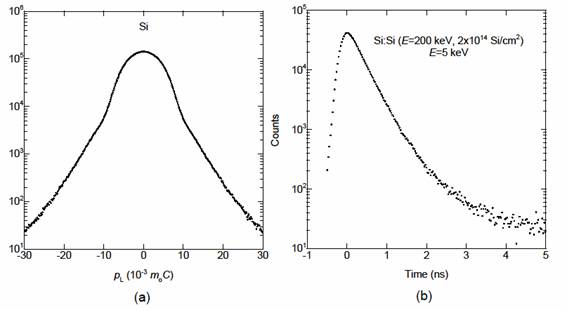
図2.Siの消滅γ線ドップラー拡がりと陽電子寿命スペクトル.
図3には,陽電子が空孔型欠陥に捕獲される様子を模式的に示した.陽電子は正の電荷を持ち,イオン殻から反発力を受けるため,なるべく格子間位置に存在しようとする(図3(a)).一方,陽電子は固体に入射した後,最大で200 nm程度は拡散することができるため,空孔型欠陥に捕獲される可能性がある(図3(b)).この場合,陽電子は空孔型欠陥中の電子と消滅することになるが,その電子運動量分布は,格子間位置の電子とは異なるので,ドップラー拡がりに変化が現れる.多くの場合,陽電子が空孔型欠陥に捕獲されることによりDEgは小さくなり,ドップラー拡がりは先鋭化する.われわれはこの変化をSパラメーター(Shape parameter)で評価する.図中にSの定義を示す.ここで,ドップラー拡がりの中央部分のカウントを全カウントで割る(中央部分のカウントを計算するためのウィンドウは固定する).すなわち,空孔型欠陥に陽電子が捕獲されるとSの値は大きくなる.Sは欠陥の種類によっても変化し,空隙サイズが大きくなるほどSの値は大きくなる(図3(c)).

図3.空孔型欠陥による陽電子の捕獲と対応するドップラー拡がりスペクトルの変化.
空孔型欠陥中は電子密度が低いため,陽電子が空孔に捕獲されると,その寿命は長くなる.たとえば,Si中の平均陽電子寿命は約220 psであるが,単一原子空孔では約260 ps,複空孔では約300 psとなる.よって,陽電子寿命を測定することによっても欠陥の同定が可能である.図2(b)には,イオン注入Siの損傷領域で陽電子が消滅した場合の寿命スペクトルを示す.寿命スペクトルは指数関数なので縦軸を対数で描けばその傾きの逆数が陽電子寿命となる.
陽電子を空孔検出ツールとして使用するなら,その検出感度について知っておくことは重要である.例えば,陽電子はSi中の中性の単一原子空孔には1016 cm-3程度の密度から捕獲され始める.ただし,欠陥サイズが2倍(複空孔)になれば感度は2倍,欠陥の電荷が中性から負へ変化した場合は,検出感度は10倍程度上昇する.逆に,中性から正へ変化すると,その欠陥にはほとんど捕獲されなくなる.よって,温度変化や光照射で空孔型欠陥の電荷が変化する場合は,陽電子の検出感度が大きく変化するので,欠陥の荷電状態についての知見を得ることができる.
図4には,状態分析方法としての陽電子消滅のポジションを示す.ここで,不純物など異種原子の状態分析方法と微量分析は除外してある.空孔型欠陥に感度がある手法ほど縦軸上部へ記入することにする.たとえば,縦軸の最上部は単一原子空孔に感度がある検出手法である.反対に縦軸(下)は自己格子間原子への感度である(縦軸の原点付近はアモルファス状態).横軸は,深さ方向にどれだけ感度があるかを示す. たとえば,X線回折は結晶性の評価が可能であるが,深さ方向に感度が無いので横軸左端のポジションとなる.また,点欠陥により電気的特性が変化することがあるが,やはり深さ方向に感度がない.AFMやRHEEDは表面の欠陥に敏感な手法である.断面SEM,TEM(XSEM,XTEM)からは,高精度な深さ方向の情報を得ることが出来るが,点欠陥をこれらの手法で研究する例はほとんど無い.ラザホード後方散乱法(RBS)からは,深さ方向の情報が得られるが,空孔型欠陥よりも格子間型欠陥に感度が高い.結局,陽電子消滅(PAS:Positron Annihilation Spectroscopy)はRBSと電子顕微鏡の中間あたりに位置する.陽電子消滅は,格子間型欠陥に感度が無いが,たとえば,陽電子の実験パラメーターに変化が出なくても,少なくとも空孔型欠陥は対象としている試料の物性に関与していないという結論は出せるので,曖昧さは無い.

図4.陽電子と他の測定方法の比較(陽電子ポジションマップ).
実際に陽電子消滅を用いて,イオン注入により表面近傍に導入された空孔型欠陥の検出を行った例を紹介したい4).試料はSiで,200 keVのSi+イオンを2×1014 /cm2まで注入した.この試料について,陽電子の打ち込みエネルギーを0.1-30 keVまで変化させてSパラメーターを観測した結果を図5に示す.陽電子の打ち込みエネルギー(E)に対応した陽電子平均飛程を横軸上に示す.Eが25 keV以上で飽和しているのは,この領域で陽電子はイオン注入欠陥が存在する領域よりも深く打ち込まれ,欠陥が無い領域で消滅するからである.一方,E = 5keV付近でSの値が上昇しているのは,陽電子がイオン注入欠陥に捕獲されているためである.図5の結果を陽電子の拡散を考慮した式で解析することによりSの深さ分布を得ることが出来る.結果を図6に示す.図より,表面から約400 nmまでSの値が大きい領域,すなわち空孔型欠陥が存在することがわかる.モンテカルロ法(TRIM)により計算したイオン注入分布と比較すると,欠陥の分布はイオンの飛程より表面へシフトしている.損傷領域の陽電子寿命は302±3 psとなったので,主な欠陥は複空孔であると結論できる.
ここでは,水素とイオン注入欠陥の相互作用を調べるため,水素プラズマにより水素を試料中へ導入した.図5より,水素処理後(HAT: Hydrogen Atomic Treatment)は表面近傍のSの値が減少することが分かる.この領域は表面から約100 nmで,SIMSにより測定した水素の分布とよく一致した(図6).詳しい解析から,Sの低下は,欠陥密度が減少したのではなく,水素が空孔欠陥に捕獲されることにより,欠陥中の電子運動量分布が変化したためであることが分かった4).なお,HATでは基板温度が190℃になるので,窒素雰囲気で190℃まで焼鈍した結果も図5と図6に示している.図6より,焼鈍後,空孔型欠陥の分布が表面方向へ移動し,欠陥サイズも若干大きくなっている(Sの上昇)様子が分かる.
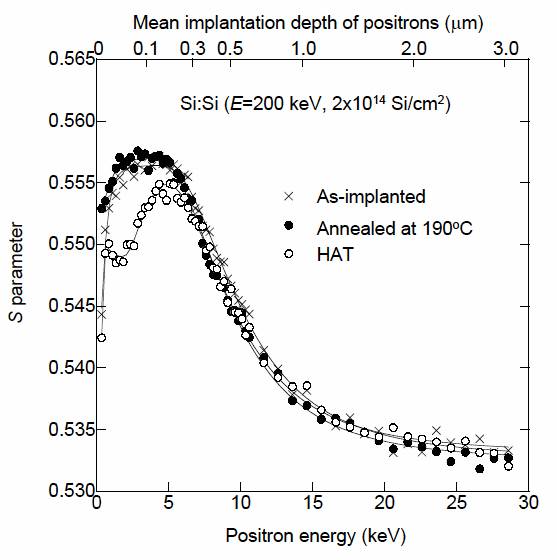
図5.Si+を注入したSiについて,陽電子打ち込みエネルギーの関数としてSパラメーターを測定した結果.
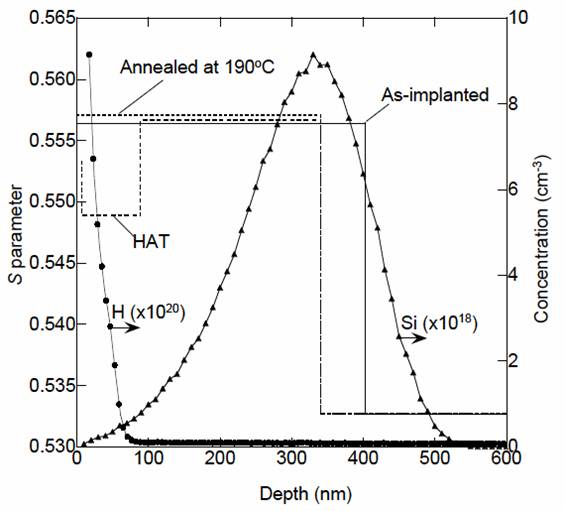
図6.図5を解析することによって求めたSパラメーターの深さ分布.
3.結語
本稿では,陽電子消滅の原理や半導体のプロセス欠陥を検出した例について紹介した.TEMやSIMSでは検出できない点欠陥の非破壊深さ分布検出,また,その等時焼鈍過程についての研究が陽電子消滅を用いて可能である.現在,力をいれているのは,半導体材料の評価で,各種のSi基板(SOI基板等),High-k材料,Low-k材料,金属薄膜,レジスト材料,また,発光デバイスや高性能太陽電池のための化合物半導体等である.半導体デバイス材料は,無機,有機を問わず,最先端材料が次々と導入される分野であり,評価対象に制約の少ない陽電子消滅がシームレスに活躍できる分野である.言うまでも無く,陽電子消滅だけで全てが解明できる訳ではなく,多くの評価法から得られた情報の活用や,それらの結果と陽電子から得られた結果の相関性の評価をバランスよく行っていくことが重要である.
文献
1) 上殿明良, 谷川庄一郎,まてりあ 35, 140-146 (1996).
2) 上殿明良,谷川庄一郎,応用物理 64, 43-46 (1995).
3) 上殿明良, 谷川庄一郎,高分子 44, 136-140 (1995).
4) A. Uedono, T. Mori, K. Morisawa, K. Murakami, T. Ohdaira, R. Suzuki, T. Mikado, K. Ishioka, M. Kitajima, S. Hishita, H. Haneda and I. Sakaguchi, J. Appl. Phys. 93, 3228-3234 (2003).